
Misure di diffrazione di raggi X ad alta risoluzione (HR-XRD) di semiconduttori composti
2023-09-16 10:00L'XRD ad alta risoluzione (HR-XRD) è un metodo comune per misurare la composizione e lo spessore di semiconduttori composti come SiGe, AlGaAs, InGaAs, ecc.
Quando vengono aggiunti droganti o impurità a acristallo singoloreticolo in modo di spostamento, il reticolo si sforzerà a causa della presenza di atomi droganti. Ad esempio, in un reticolo di Si, la presenza di atomi di Ge provoca una deformazione di compressione perché gli atomi di Ge sono più grandi degli atomi di Si nel reticolo. Questa deformazione modifica la spaziatura del reticolo di Si e questa differenza di spaziatura può essere rilevata da HR-XRD.

Figura 1: Scansione teorica HR-XRD di una struttura generale sottoposta a deformazione di compressione, come uno strato di SiGe da 10 nm su un substrato di Si. I picchi a 0 gradi provengono dal reticolo di Si nel substrato.
La presenza di atomi di Ge più grandi fa sì che gli atomi di Si nello strato di SiGe siano più distanti, facendo spostare il picco di diffrazione verso un angolo inferiore (a sinistra del picco del substrato). Poiché lo strato di SiGe da 10 nm è più sottile, il picco di diffrazione dello strato di SiGe è molto più ampio di quello del substrato di Si.
In tali pellicole, solo poche file di atomi con una certa disposizione possono essere utilizzate per produrre un segnale di diffrazione, e ilDiffrazione di raggi Xil picco è più ampio della diffrazione da un substrato di Si, perché ci sono migliaia di righe nel substrato che possono essere utilizzate per produrre la sequenza atomica dei segnali di diffrazione. Se la struttura è sottoposta a sollecitazione di trazione, gli atomi di Si saranno più ravvicinati rispetto agli atomi di Si nel substrato e il picco di diffrazione corrispondente si sposterà a destra del picco del substrato. I picchi extra nello spettro, chiamati"striature di spessore,"provengono da una maggiore interferenza dei raggi X riflessi dall'interfaccia tra lo strato di SiGe e il substrato di Si. Questo è lo stesso segnale utilizzato per l'analisi della riflettanza dei raggi X (XRR) e può essere utilizzato per determinare lo spessore dello strato di deformazione.
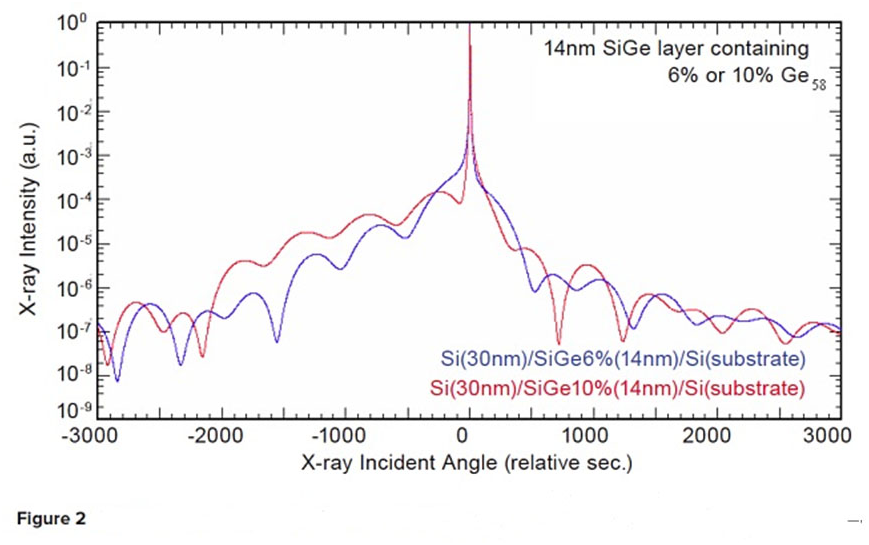
Questo metodo può essere utilizzato per determinare la composizione dello strato di deformazione. La Figura 2 mostra una scansione HR-XRD teorica di due campioni, cresciuti da un Si da 30 nm su un SiGe da 14 nm su un substrato di Si. Nel primo caso nel reticolo è presente il 6% di Ge, mentre nell’altro caso è presente il 10% di Ge. HR-XRD può facilmente distinguere tra queste due strutture e determinare lo spessore dello strato in base alla frangia di spessore.
Inoltre, tecniche di modellazione avanzate consentono descrizioni accurate delle caratteristiche strutturali, come gli strati di SiGe con strutture graduate. HR-XRD può misurare una varietà di materiali epitassiali, come AlGaAs, InGaAs, InGaN, ecc. In generale,XRDpuò determinare la composizione di questi strati di film sottile con una precisione inferiore all'1%. Tuttavia, va notato che HR-XRD presuppone che tutti gli atomi droganti siano presenti nel reticolo.
