
Applicazione della tecnologia XRD nell'industria dei semiconduttori
2023-09-20 10:00La spesa globale per le apparecchiature per semiconduttori è entrata in un ciclo ascendente. L’applicazione di nuove tecnologie e nuovi prodotti come 5G, Internet of Things, big data, intelligenza artificiale ed elettronica automobilistica porterà un’enorme domanda sul mercato dei semiconduttori e l’industria entrerà in un nuovo ciclo di crescita. La produzione di wafer, la crescita epitassiale, il confezionamento e l'integrazione nella parte anteriore dell'intera catena industriale, nonché la qualità del processo e del prodotto sono direttamente correlati alle applicazioni industriali a valle. Rigaku ha un sistema completo di attrezzature, come ad esempioDiffrazione di raggi X(XRD), fluorescenza a raggi X (XRF), riflettometro a raggi X (XRR) e topografia a raggi X (XRT), che possono essere applicati all'intero processo, dalla produzione di wafer ai circuiti integrati, e possono effettuare misurazioni non distruttive di una serie di parametri chiave del processo: come lo spessore , composizione, rugosità, densità, porosità, nonchéstruttura di cristalloe difetti della struttura cristallina.
1. Nella produzione dei wafer, il numero e il tipo di difetti influenzeranno notevolmente le fasi successive. L'imaging topologico a raggi X (XRT) può osservare chiaramente difetti e dislocazioni sulla superficie del wafer (Figura 1). Aiutare i produttori a migliorare il processo e controllare la qualità.
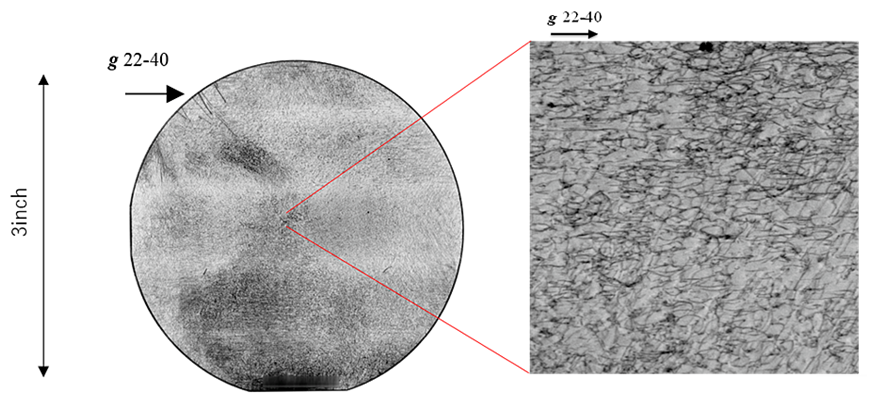
Figura 1: Imaging della topologia di trasmissione di un wafer 4H-sic
2. È possibile misurare l'uniformità del wafer o della pellicola epitassialeXRDla funzione di curva di oscillazione e il modulo software di visualizzazione fornito da Rigaku possono anche fornire immagini di distribuzione bidimensionali, che possono valutare intuitivamente la qualità della superficie (Figura 2).
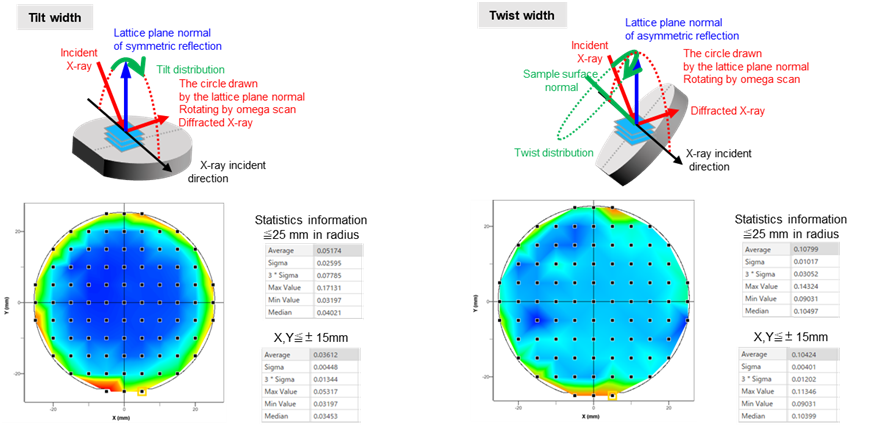
Figura 2: Immagine bidimensionale della pellicola AlN che cresce su substrato di zaffiro
3. Lo spessore della pellicola può essere misurato mediante una curva di oscillazione ad alta risoluzione, non distruttiva ed estremamente precisa (Figura 3).

Figura 3: Curva di oscillazione ad alta risoluzione per la misurazione dello spessore delle pellicole GaN/InxGa(1-x)N
4. Potrebbe verificarsi qualche tipo di disadattamento del reticolo durante la crescita del wafer o della pellicola epitassiale, che influirà sulla qualità della pellicola. Utilizzando gli speciali rilevatori e le soluzioni di Rigaku, è possibile eseguire test spaziali reciproci su SmartLab, dove disallineamenti reticolari ecristallograficole costanti possono essere viste in modo molto intuitivo.
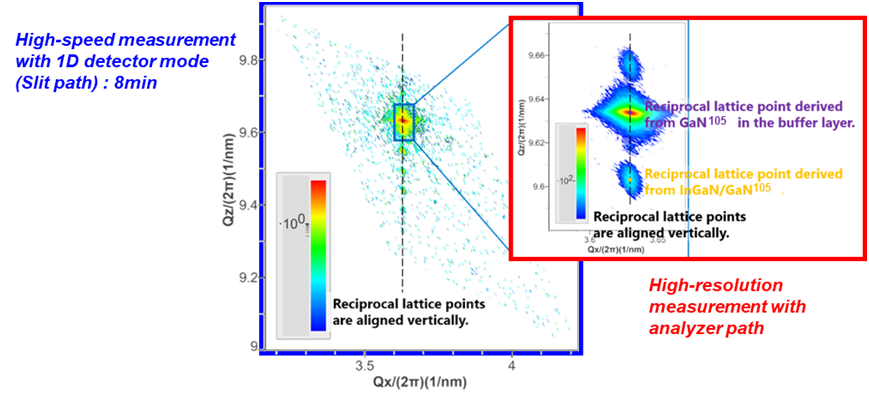
Figura 4: spettro spaziale reciproco ad alta risoluzione di GaN105
